半導体製造プロセスの改善とその先に向けて
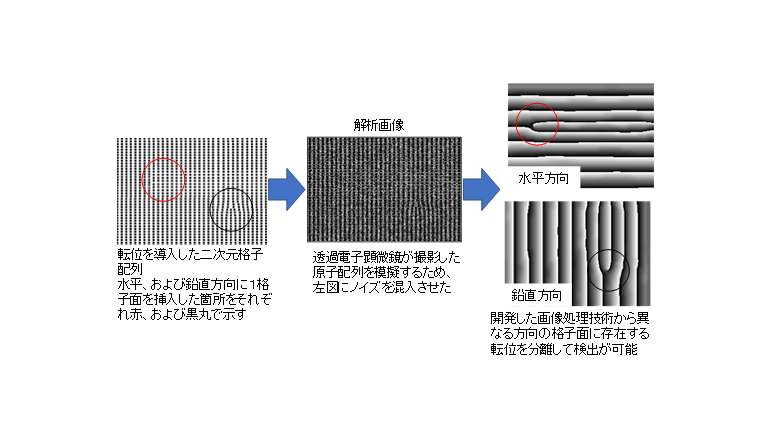
半導体の性能・寿命を保証するため、半導体デバイスの製造時に発生する構造欠陥を精密に制御するプロセス技術の確立が求められている。
原子レベルの欠陥はこれまで、透過電子顕微鏡で撮影された高分解能原子配列画像を人が観察し評価していたが、高倍率にするほど視野が狭くなるため、広い領域で欠陥を評価するには非常に手間が掛かっていたという。産業技術総合研究所の分析計測標準研究部門 津田 浩 総括研究主幹、同部門 非破壊計測研究グループ 李 志遠 主任研究員、王 慶華 研究員と、東芝デバイス&ストレージは共同で、結晶の透過電子顕微鏡画像の広い領域で欠陥を容易に検出できる画像処理技術を開発した。
欠陥検出にモアレ縞(格子間隔が近い二つの格子を重ねたときに現れる周期的な模様)を利用する。今回の開発技術では、結晶の原子配列を規則的な格子と見なし、サンプリングモアレ法からモアレ縞を作成。モアレ縞は結晶格子を拡大した模様に相当することから、格子に変形をもたらす転位が存在する箇所ではモアレ縞に不連続な変化が現れる――との考えを検証するため、シミュレーションを行った。画像処理技術をGaN半導体の透過電子顕微鏡画像に適用すると、画像全体で欠陥の一種である転位の分布を評価することができた。
原子配列を拡大したサンプリングモアレ縞の位相図は明瞭で、転位を示すモアレ縞の終点や分岐点が目視でも容易に確認できる。GaN層では中心部における転位が少なく、保護層やAlGaN層との界面近くには多くの転位が存在した。AlGaN層では、層全体に均一に転位が分布していて、転位密度は他の層よりも高かった。また積層方向に垂直なX軸格子の転位は、GaN層とAlGaN層の界面に集中していることが分かったという。
製造プロセスが転位分布に及ぼす影響を評価することで、転位の少ない高性能、長寿命の半導体デバイスの製造プロセスの確立が期待される。技術の詳細は、今月19日(現地時間)に英国科学誌Nanotechnologyのオンライン版にAccepted Manuscriptとして掲載された。また、22日に国際会議「2017 International Conference on Solid State Devices and Materials」にて発表される。
産総研と東芝デバイス&ストレージは今後、半導体デバイスの製造プロセス改善に繋げる取り組みを継続しながら、汎用の透過電子顕微鏡画像解析システムとして画像処理ツールの提供や解析技術の製品化を目指す構えだ。
